ニュースリリース
2025年6月 5日
三菱マテリアル株式会社
「角型シリコン基板」が「半導体・オブ・ザ・イヤー2025 半導体用電子材料部門」にて優秀賞を受賞
~半導体パッケージ製造を支える製品として高い評価を獲得~
三菱マテリアル株式会社は、株式会社産業タイムズ社主催の「半導体・オブ・ザ・イヤー2025」の半導体用電子材料部門において、2024年8月に発表した半導体パッケージ向け「角型シリコン基板」(*1)が高く評価され、半導体用電子材料部門の優秀賞を受賞しました。
今年で31回目となる本賞は、半導体製品の開発の斬新性・量産体制の構築・社会に与えたインパクト・将来性などを基準に選定するもので、当社では初の受賞となります。
- (*1)
- 2024年8月21日プレスリリース 「半導体パッケージ向け「角型シリコン基板」を開発」
URL:https://www.mmc.co.jp/corporate/ja/news/press/2024/24-0821.html


「半導体・オブ・ザ・イヤー2025」授賞式の様子(2025年6月4日開催)
(左写真、左から
高機能製品カンパニー 三田工場 技術開発室 片瀬琢磨、
高機能製品カンパニー 電子材料事業部長 増田昭裕、
高機能製品カンパニー 三田工場長 吉田能弘)
【「半導体・オブ・ザ・イヤー2025」について】
本賞は、2024年4月~2025年3月に企業が既存製品のバージョンアップや新製品として発表した製品・技術を対象に選出されたものです。また、①半導体デバイス、②半導体製造装置、③半導体用電子材料の3部門があり、開発の斬新性・量産体制の構築・社会に与えたインパクト・将来性などを基準として、同紙記者の厳正な投票によって選出されました。
【当社の半導体パッケージ向け「角型シリコン基板」について】
近年、チップレット技術を採用した先端半導体パッケージ(*2)は100mm角程度まで大型化しています。従来のWLP(Wafer-Level-Package(*3)ではインターポーザー(*4)として円形のシリコンウェーハを使用するため、搭載できるパッケージが限定的で、効率的な配置が課題となっていました。その課題を解決するため、当社は大型シリコンインゴットの鋳造技術と独自の加工技術を組み合わせた四角形状の「角型シリコン基板」を開発しました。
2024年8月の公表以来、半導体デバイス、半導体デバイス装置メーカー、副資材メーカーより多数のサンプル要求をいただいており、次世代半導体分野における生産性向上に貢献すべく、量産化を目指し取り組んでまいります。
- (*2)
- 半導体素子の放熱や外部からの保護、外部との電気的接続、プリント基板への実装性向上などのため、半導体素子や集積回路を樹脂等で封止した複合部品のこと。
- (*3)
- ウェーハ基板上で最終工程まで処理して完成させる半導体パッケージのこと。
- (*4)
- 半導体パッケージの三次元実装において、貫通電極によって表裏の回路の導通を取るために用いられる基板のこと。
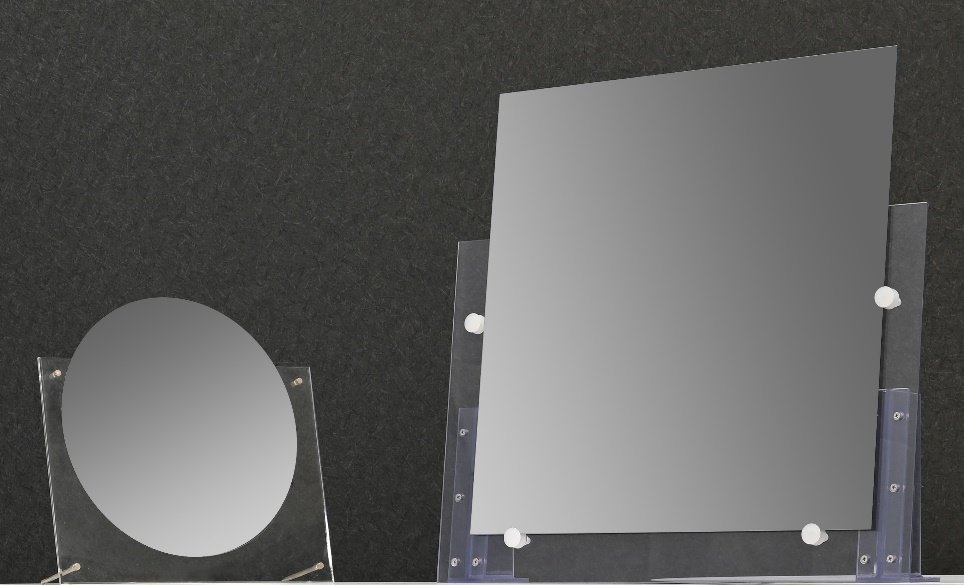
角型シリコン基板(サイズ例510mm×515mm×0.8mm)の外観(右)
(左はφ300mm単結晶シリコンウェーハ(サイズ比較用))
当社グループは、「人と社会と地球のために、循環をデザインし、持続可能な社会を実現する」ことを「私たちの目指す姿」と定めています。今後も新たなマテリアルを創造し、オンリーワンの高機能素材・製品供給を行うとともに、お客さまのご要望に合わせた最適なソリューションを提供することで、目指す姿の実現に取り組んでまいります。
以上
<本件に関するお問い合わせ>
広報室:03-5252-5206