ニュースリリース
2014年3月28日
次世代パワーモジュール用高性能絶縁回路基板「Ag焼成膜付きDBA基板」を開発
三菱マテリアル株式会社(取締役社長:矢尾 宏、資本金:1,194億円)は、ハイブリッド(HV)自動車向けなどの電源制御用のインバータなどに今後採用が期待されている高温半導体素子搭載用の絶縁回路基板として、アルミニウム(Al)回路上に銀(Ag)の焼成膜を直接形成した、次世代パワーモジュール用の高性能絶縁回路基板「Ag焼成膜付きDBA(Direct Bonded Aluminum)基板」を開発しましたのでお知らせいたします。
【開発の背景、理由】
HV自動車向けなどの高出力モータ電源制御用インバータでは、直流・交流電力の変換時に発生する発熱に対応し電力損失を飛躍的に低減させるため、SiC(炭化ケイ素)やGaN(窒化ガリウム)といった、200℃のような高温環境下でも動作可能な高温半導体素子の利用拡大が見込まれています。
しかしながら、このような高温環境下では従来の素子接合材であるはんだ材は使用できず、耐熱性に優れるAg系の接合材が一般的に使用されますが、その使用にあたってはAl表面にめっきなどの煩雑な下地処理の必要があり、めっき液使用による環境負荷の発生や製造コスト増加といった課題がありました。
このたび当社は、当社製品である高信頼性DBA基板のAl回路上に、十分な接合力を有するAg焼成膜の形成に成功しました。
この基板では、めっき下地処理が不要となり、ナノAgなどのAg系の接合材を用いて、Al回路上に素子を直接接合することが可能となります。今後、HV自動車向けなどの電源制御用インバータにおけるSiCなどの高温半導体素子搭載用の絶縁回路基板として、自動車や鉄道向けに利用が拡大していくものと期待されます。
【主な特徴】
- ①
- Agペースト中のガラス成分を最適化することにより、Ag焼成後にAlと強固に接合した焼成膜を形成(図1)。
- ②
- 熱応力緩和効果の高いDBA基板のAl回路上に、Ag焼成膜を形成したAg焼成膜付きDBA基板(図2)であり、過酷な温度サイクル試験(-40~200℃×1000サイクル以上)においてもセラミックス割れを防止することが可能。
- ③
- この基板上に、ナノAgペーストや酸化Agペーストを用いて高温半導体素子を接合(図3)することで、高温動作可能なパワーモジュールの製造が可能。
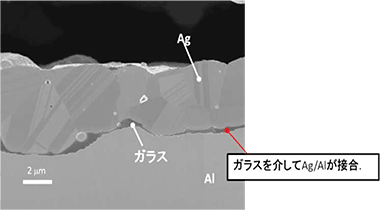 図1:Al/Ag接合部の断面観察
図1:Al/Ag接合部の断面観察
 図2:Ag焼成膜付きDBA基板の外観
図2:Ag焼成膜付きDBA基板の外観
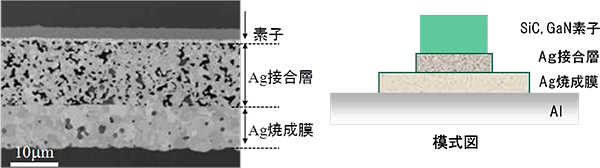 図3:素子接合の構成例
図3:素子接合の構成例
以上