プレスリリース
2013年3月29日
高スループット成膜を可能とするPZT圧電膜用ゾルゲル材料を開発
三菱マテリアル株式会社(取締役社長:矢尾 宏、資本金:1,194億円)は、今般、圧電※1 MEMS (メムス:Micro Electro Mechanical Systems)※2 デバイス向けに、従来よりも約4倍の高スループット※3成膜を可能にするPZT圧電膜用ゾルゲル材料を開発いたしましたのでお知らせいたします。
チタン酸ジルコン酸鉛(PZT)膜を搭載した圧電MEMSデバイスは、インクジェットヘッドをはじめRFスイッチなどのアクチュエーター用途やジャイロセンサーや振動センサーなどのセンサー用途において実用化が始まっており、将来のエナジーハーベスター※4としても注目を集めています。PZT膜の成膜手法としては現在、スパッタリング法とゾルゲル法※5 がありますが、スパッタリング法はプロセスコストが高いといった課題があることから、当社ではより安価な非真空プロセスであるゾルゲル法用の材料開発を行ってきました。
しかしながら、これまでのゾルゲル法では、良好な圧電特性実現のため数10ナノメートルの厚さの膜を数十回積層させ、圧電MEMSデバイスに要求されるミクロンオーダーの膜厚を得る必要があるため、プロセス時間が長いことが量産上の課題とされていました。今回当社が開発したゾルゲル法では、1回の成膜工程で得られる膜厚を増大させるべく、ゾルゲル材料の組成や成膜プロセスを改良した結果、膜厚を約400ナノメートルとすることで、積層回数の大幅な削減を可能にしたものです。これにより、成膜スループットを8.8μm/hにするとともに、膜の圧電定数を-15 C/m²とデバイスとして実用上十分な数値であることを確認できました。
当社はすでに三田工場において、膜形状の素子を製造する技術として、スパッタリング法と比べより低コストのゾルゲル法向けに、圧電膜製造用のPZT系ゾルゲル材料を製造・販売しておりますが、今回の開発ではこれまでの膜形成技術をさらに高度化し、従来のゾルゲル法と比べて約4倍となる、極めて高い成膜スループットを実現したものとなります。本開発成果は、本年4月9日に米国ワシントンDCで行われるPiezoMEMS 2013ワークショップで報告する予定です。
当社では、本開発技術を向上させるため、今後は成膜装置メーカーとも協力し、MEMS市場で求められる8インチSiウェーハサイズでの量産成膜プロセスを構築してまいります。
- ※1 圧電(材料)
- 圧力を加えると分極を示し、逆に電圧を加えると変形する機能材料。
- ※2 MEMS(メムス)
- 機械要素部品、センサー、アクチュエーター、電子回路を一つの基板上に集積化したデバイス。
- ※3 成膜スループット
- 1時間で得られる膜厚。
- ※4 エナジーハーベスター
- 光や振動、熱などの周囲の僅かなエネルギーを電力に変換するモジュール。
- ※5 ゾルゲル法(湿式プロセス)
- 有機金属化合物の溶液(ゾルゲル材料)を基板に塗布し、乾燥してゲル膜を得、その後焼成することで、基板上に金属酸化物の膜を得る成膜方法。
図1 成膜スループットの向上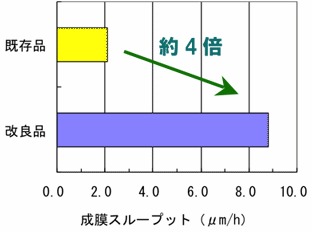
図2 4インチSiウェーハ上のPZT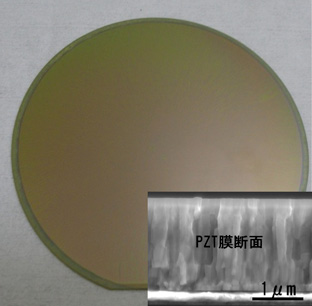
以上